
 |
||||
|
||||||||||||||
|
ВВЕДЕНИЕ
Принципиальное различие прямой и обращенной литографии заключается в способе формирования рисунка токопроводящего металлического слоя. В прямой литографии подложка первоначально покрывается слоем металла, а затем на металлический слой наносится пленка фоторезиста. После процессов экспонирования, проявления и травления металлический слой удаляется с незащищенных фоторезистом участков. В технологии обращенной литографии на подложку сначала наносится пленка фоторезиста. После процессов экспонирования и проявления в пленке фоторезиста вскрываются участки, где предполагается осуществить металлизацию подложки. Затем вся поверхность, включая поверхность пленки фоторезиста и вскрытые участки подложки, покрываются металлом. На следующей стадии пленка фоторезиста удаляется с подложки с помощью подходящего растворителя вместе с осажденным на пленку металлом. Металлический слой сохраняется только на подложке во вскрытых окнах, оставляя желаемый рисунок металлизации. Характерным признаком обращенной литографии является отсутствие стадии травления. Импульсом для разработки технологии обращенной литографии явилась необходимость формирования металлических токопроводящих дорожек на полупроводниковых подложках, где использование химического или плазменного травления является нежелательным или несовместимым с технологией или материалами. Примером этого может служить технологическая операция на подложках арсенида галлия. Другая причина - это обеспечение надежного контроля над размерами элементов. Химическое травление является изотропным по природе. Вследствие этого трудно контролировать ширины линии металла из-за подтравливания металла под маской резиста. В технологии обращенной литографии травление отсутствует и ширина формируемых металлических дорожек зависит только разрешения пленки фоторезиста Стандартные позитивные фоторезисты невозможно использовать в обращенной литографии из-за положительного наклона профиля стенок резиста, что обусловлено объемным эффектом. Ультрафиолетовое излучение при прохождении через пленку поглощается, в результате верхние слои пленки получают более высокую дозу энергии, чем нижние. Вследствие этого верхние слои пленки будут быстрее растворяться в проявителе, профиль резиста становится пологим, уширенным вверху и уменьшенным внизу у основания. Обычно этот положительный наклон составляет 75 - 85 0С в зависимости от условий процесса и характеристик оборудования для экспонирования. При нанесении слой металла осаждается на боковых стенках пленки фоторезиста, что сделает затруднительным последующее удаление пленки фоторезиста растворением. Фоторезист ФПН-20-ИЗО обеспечивает отрицательный наклон профиля стенки. Достигается это с помощью обращения скрытого позитивного изображения. На рисунках 1-7 показаны основные стадии обращения изображения маски. 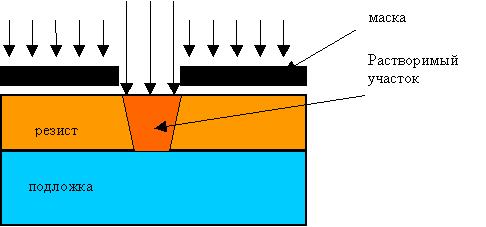 Рис.1. Экспонирование резиста и возникновение скрытого позитивного изображения 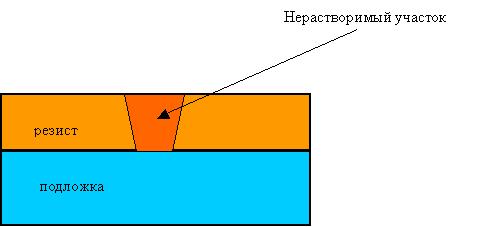 Рис.2. Термическая обработка пленки резиста 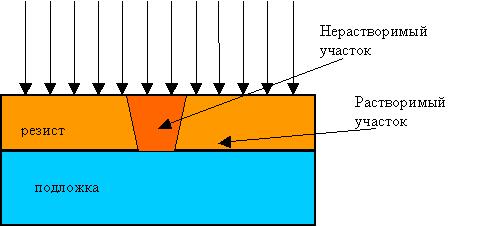 Рис.3. Сплошное экспонирование пленки (без маски) 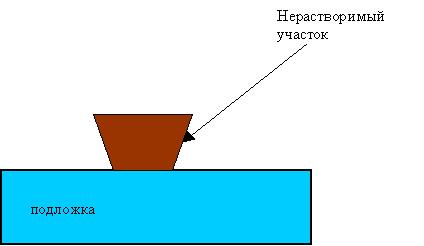 Рис.4. Проявление пленки. Отрицательный наклон позволяет воспроизводимо удалять пленку металла, нанесенную посредством термического или плазмохимического напыления, даже в том случае, когда толщина слоя металла превышает толщину пленки фоторезиста ("взрывная литография", рис.5 и 6). В случае стандартного позитивного фоторезиста "взрывную литографию" осуществить не удастся (рис. 8) 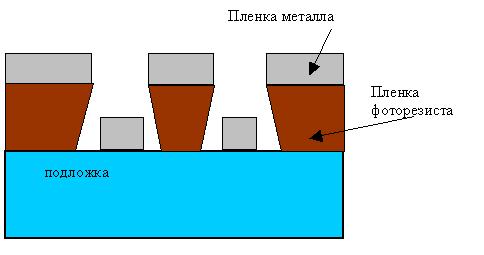 Рис.5. Взрывная литография. Толщина слоя металла мала 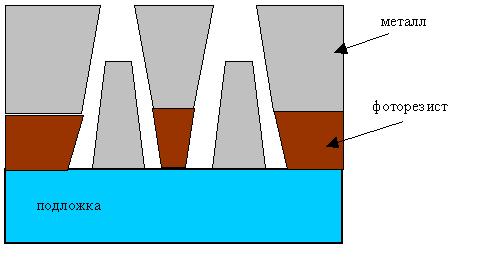 Рис.6. Толщина слоя металла превышает толщину пленки фоторезиста пленка металла 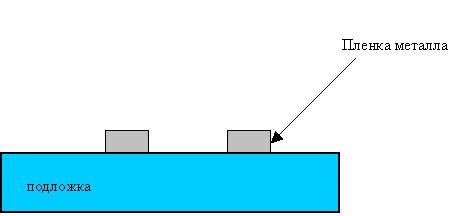 Рис.7. Снятие фоторезиста 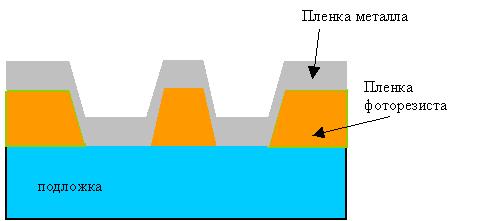 Рис.8. Осаждение металла на пленку
стандартного позитивного фоторезиста. 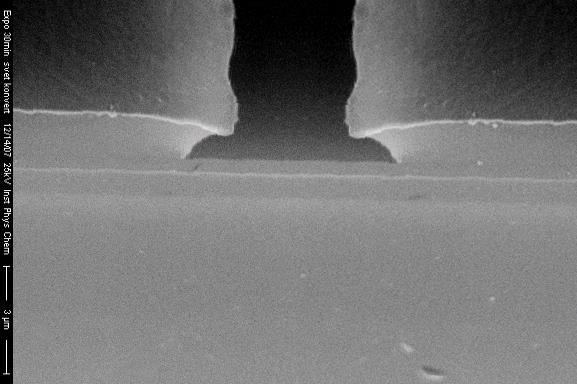 Рис.9. Фотография пары линий ФПН-20-ИЗО в поперечном сечении, полученная на электронном микроскопе. Хорошо виден отрицательный наклон линий. Инструкция по применению фоторезиста для взрывной литографии ФПН-20-ИЗО Общии сведения Фоторезист ФПН-20-ИЗО является позитивным фоторезистом, однако, способен к обращению изображения с образованием негативного образа маски. Данный фоторезист предназначен для использования в технике взрывной литографии. В отличие от позитивного процесса в технике взрывной фотолитографии отсутствует стадия травления подложки, но включены две другие стадии - это стадия обращения изображения и нанесения металла. Отзывы потребителей фоторезиста ФПН-20-ИЗОСписок публикаций о применении фоторезиста ФПН-20-ИЗООсновные стадии Технология применения фоторезиста ФПН-20-ИЗО включает восемь следующих основных стадий:
Оптимизация Рассмотрим более подробно отдельные этапы
Следует заполнить следующую таблицу:
* условия обращения - оптимальные * время проявления - 60 сек Доза экспонирования выбирается минимальной, при которой остаточная толщина негативного изображения составляет примерно 90% от начальной толщины. Условия обращения изображения - это оптимальные условия, установленные на стадии 3 Безопасность и хранение Условия безопасного обращения с фоторезистом ФПН-20-ИЗО стандартные для позитивных фоторезистов. Условия хранения, однако, несколько отличаются. Фоторезист ФПН-20-ИЗО следует хранить в исходной бутылке из коричневого стекла при температуре 10-15 0С. Срок гарантийного хранения 6 месяцев. Перед применением фоторезист в закрытой бутылке выдерживают при комнатной температуре не менее 1 часа. |
||||||||||||||||||||||||||||||||||||||||||||||||||||
|
|||||||||||||
|
||||